随着电子设备向小型、多功能、大功率及高可靠性方向的快速发展,微电子器件高密度的三维集成技术应运而生。然而,高密度集成的发展受限于芯片热集中引起的高结温问题,严重导致器件性能和可靠性的下降。
集成芯片内部为多层结构组合而成,依次为基板层、芯片电路层、芯片、封装壳体冷板。封装壳体冷板内部设计有微通道,通过液体对流换热带走电路层芯片的热量,并保证芯片均温性。封装壳体冷板与电路层之间采用柔性导热界面材料(TIM)过渡连接。
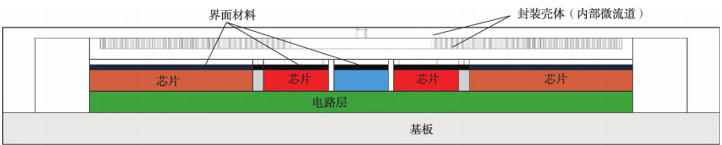
集成芯片散热示意图
导热界面材料是一类重要的散热材料,它们用于填充两个表面之间的微小空隙,直接改善散热性能。TIM通常应用于芯片与封装盖(TIM1)、芯片与散热器(TIM1.5)、封装盖与散热器之间(TIM2)。高导热性、高可靠性的TIM能够保障热量在界面的快速传递。目前高算力芯片主流的散热方案还是通过超低热阻的TIM1材料将芯片内部的热量快速传导到封装外壳上,然后再通过TIM2材料将热量再次传导至液冷板上,液冷板通过内部冷却工质的快速流动将热量快速的传递到外部环境。
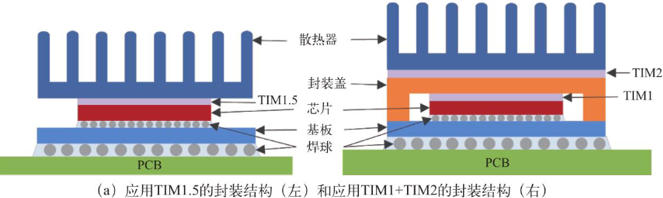
另外,在封装工艺中,低温键合技术得到了广泛应用。例如低温Cu-Cu键合技术因其在高密度互连、良好的导电性和导热性方面的优势,成为先进封装的核心技术之一。纳米银烧结工艺是低温键合技术的典型代表,可在250℃的低温条件下形成250 W/(m·K)高热导率的连接界面,有效避免了传统高温工艺带来的热致损伤。该工艺获得的连接结构孔隙率极低、热传导特性优异、机械稳定性突出,为先进封装提供了可靠保障。
